Research Equipment
External research institutions can apply for access to our research infrastructure through collaborative projects or via the ForLab network. Industrial partners have the opportunity to collaborate within the framework of third-party industry funded projects. Your contact person is Prof. Dr. Stefan Tappertzhofen

Analysis Tools
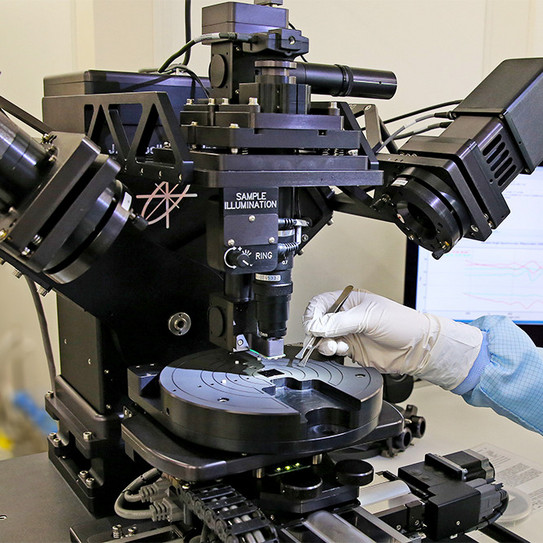
Description:
Ellipsometer
Features:
Layer thickness measurement and parameter extraction

Description:
Scanning electron microscope (SEM)
Features :
Deben Beam Blanker, Kleindiek Nanotechnik Stage, Xenos Pattern Generator, Resolution down to 0,7nm
In Cooperation with Terahertz Spectroscopy Group (AG Lange)
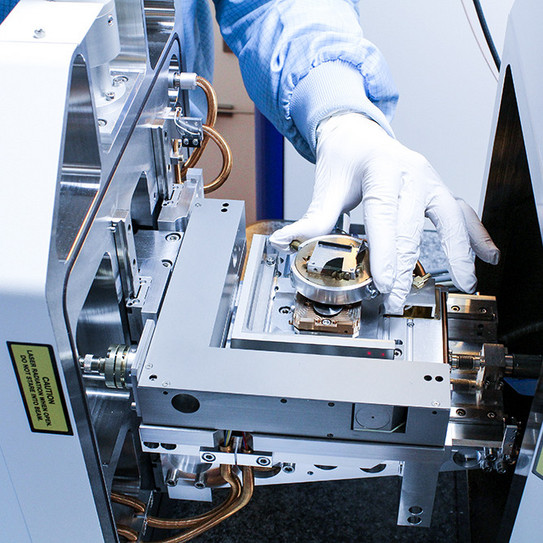
Description:
Scanning electron microscope (SEM)
Features :
Resolution up to 10nm, InLens and SE-detector

Description:
Scanning electron microscope (SEM)
with PointElectronic Elektronik Upgrade and Raith ELPHY Quantum
Features:
Up to 10 nm resolution including a 4k imaging system, topology display, InLens-, SE- and BSE-detector

Description:
Energy-dispersive X-ray spectroscopy (EDX) system
Features:
Low-KV EDX system, ≤127eV @ MnKα, detection of elements starting from Beryllium at a minimum atomic number of Z=4 and higher

Description:
Digital optical microscope
Features:
Up to 5000x magnification
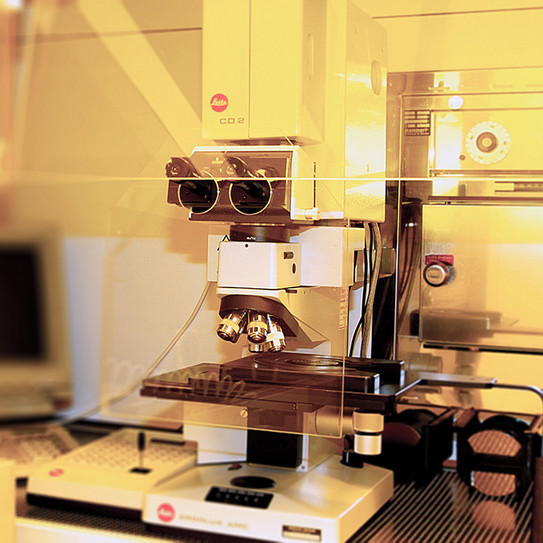
Description:
Structure Width Measuring System
Features:
Laser Autofocus
Description:
Compound microscope
Features:
Optical UIS2/UIS (Universal Infinity System)-system

Decription:
Confocal laser microscope

Description:
Profilometer
Features:
Surface profilometry up to 262 µm
Description:
Raman-Spectroscopy and Atomic Force Microscopy
Features:
2 Laser Sources (355 nm and 488 nm), Linkam-Stage (196 °C to +600 °C in variable atmosphere) with micro manipulators and probe needles, Atomic force microscopy (AFM, CAFM)

Measurement Instruments
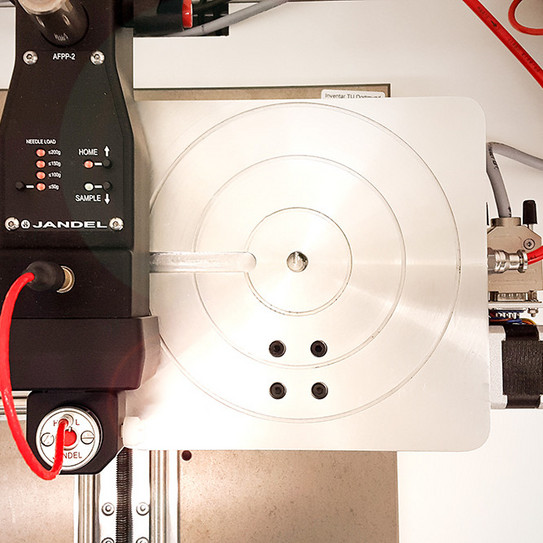
Description:
Four-point measurement system
Features:
Sheet resistance measurement on specimen pieces and wafers
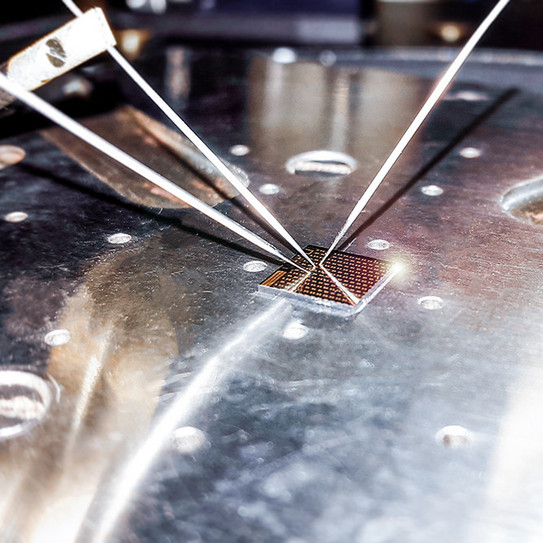
Description:
Analytical Wafer Prober
Features:
Light protected measurement station including vacuum chuck and 8 measuring needle tips

Description:
Parameter analyser
Features:
Precision Semiconductor Parameter Analyzer
Description:
Wafer prober
Features:
Full automatic wafer prober for statistic measurement of device parameters
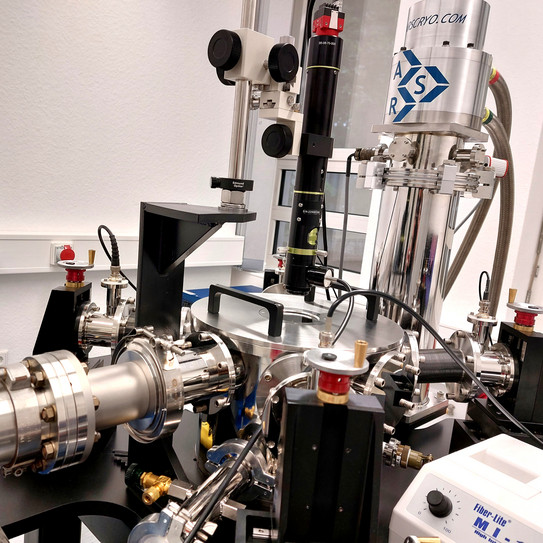
Description:
Cryogenic Probe Station
Features:
Closed Cycle, Helium Compressor, Beryllium DC probe Tips
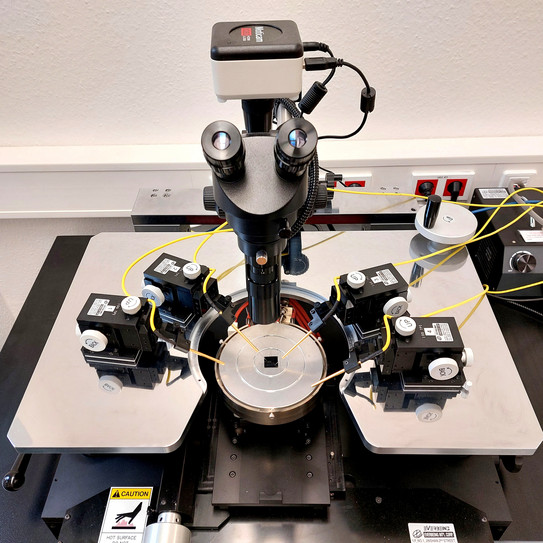
Description:
RF Wafer Prober
Features:
RF Measurements up to 40GHz, Temperature Range up to 200°C, metric screws only
Description:
Impedance Analyzer
Features:
Impedance analyzer and precision LCR meter, 1 mHz to 5 MHz, 1 mΩ to 1 TΩ
Features:
DC - 600 MHz Lock-in Amplifier, 14 bits, 1.8 GSa/s, ±150 mV, ±1.5 V (high-impedance load), -12.5 dBm, 7.5 dBm (50 Ω load), Spectrum Analyzer
Features:
Source Meter Unit (Range 1 aA - 100 mA, 1 µV - 200 V)
Features:
Source Meter Unit (0.1 fA - 10 A, 5 µV - 200 V)
Features:
Digital Nano-Voltmeter (< 1 µV - 100 V)
Features:
4x 1 GHz (5 GSPS) Oscilloscope

Etching Technology

Description:
Inductive Coupled Plasma (ICP), Reactive Ion Etching (RIE)
Features:
12 different Gaslines, Fluorine- Chlorine and Bromine-Processes, End-Point Detection
Description:
Inductive Coupled Plasma (ICP), Reactive Ion Etching (RIE)
Features:
Fluorine- and Chlorine-Processes
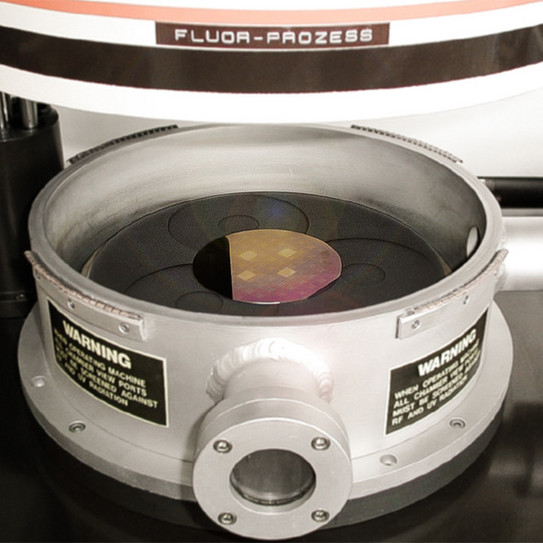
Description:
Reactive Ion Etching (RIE)
Features:
Chlorine chamber: SF6, Cl2, CHF4, SiCl4, N2; Fluorine chamber: SF6, O2, Ar, CHF3, N2

Description:
Reactive Ion Etching (RIE)
Features:
Fluorine processes: SF6, O2, Ar, CHF3, N2
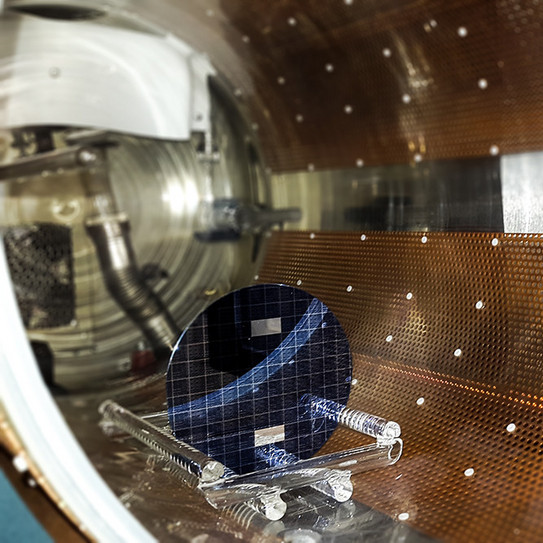
Description:
Plasma ashing
Features:
Etching via oxygen plasma, max. 8-inch wafer
Implantation and Doping Technology

Description:
Ion Implanter
Features:
Doping reaching a max. dose of 10e16 cm-2 and a max. ion energy of 350 keV.
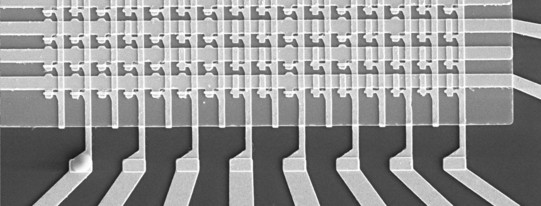
Lithography

Description:
Scanning electron microscope (SEM)
Features :
Deben Beam Blanker, Kleindiek Nanotechnik Stage, Xenos Pattern Generator, Resolution down to 0,7nm
In Cooperation with Terahertz Spectroscopy Group (AG Lange)

Description:
Electron Beam Lithography (EBL)
Features:
Patterns sizing down to 10 nm on die substrates, laser interferometer controlled stitching

Description:
E-Beam Lithography (EBL),
includes PointElectronic Upgrade and Raith ELPHY Quantum Lithography Extension
Features:
Patterns sizing down to 10 nm on die substrates
Description:
Direct exposure system
Features:
Minimum pattern resolution of 300 nm
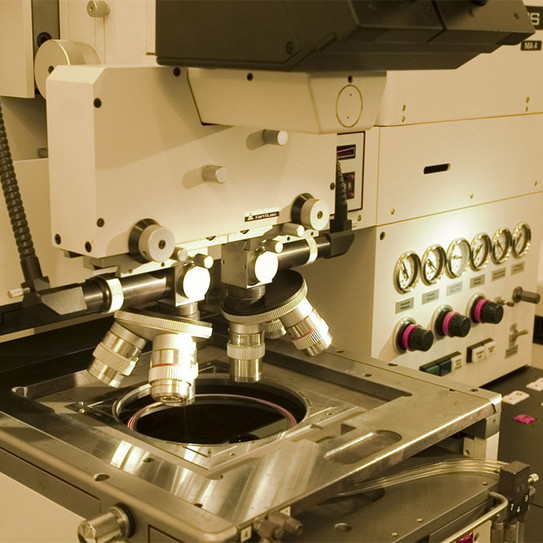
Description:
UV light exposure system, mask aligner
Features:
Structure widths down to 0,6 µm on 4 inch substrates

Description:
UV light exposure system, mask aligner
Features:
Structure widths down to 0,6 µm on 4 inch substrates

Description:
Spin coating system
Features:
Wafer sizes up to 200 mm, rotational speeds up to 12000 RPM
Description:
Spin Coating System
Features:
Wafer sizes up to 200 mm, rotational speeds up to 12000 RPM, used for silicones

Thin Film Deposition
Description:
Atomic Layer Deposition
Features:
Thermal ALD up to 500°C, Glovebox, Picozone™ PZ-100 ozone generator, Precursor: TMA, TEMAHf, H2O, NH3

Description:
Plasma Enhanced Chemical Vapor Deposition (PECVD)
Features:
Thin film deposition by Chemical Vapor Deposition
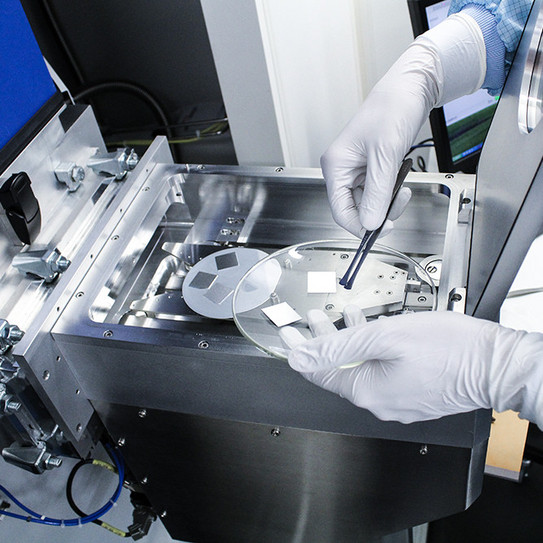
Description:
Reactive Magnetron Sputtering
Features:
Physical Thin Film Depositon (feat. Al, Ti [ TiN reactive], Ni, Si)

Description:
Reactive Magnetron Sputtering
Features:
Depostion of ITO, Lanthanum hexaboride, Samarium, Yttrium and Bismuth telluride
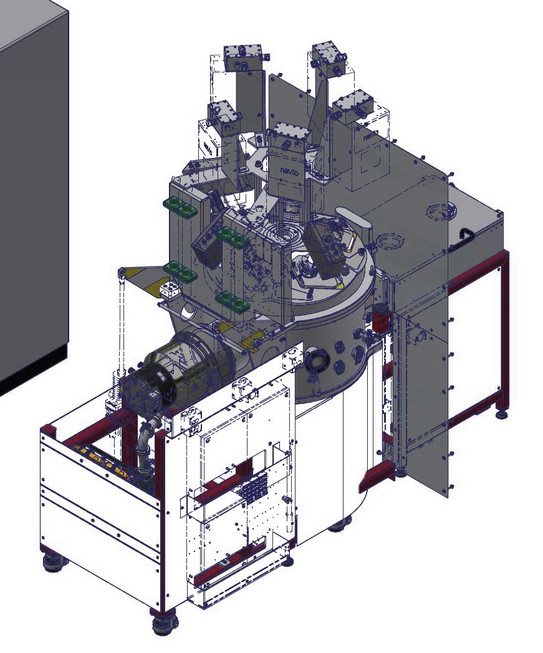
Description:
Confocal DC/RF magnetron sputtering system with plasma emission monitor (PEM)
Features:
Deposition of chromium, niobium (-oxide), and hafnium (-oxide), as well as other materials

Description:
Evaporation
Features:
Contains Al-target and Cr-target

Description:
Diffusion and oxidation furnace
Features:
Oxidation (wet and dry), H2 and N2 tempering
Description:
Low Pressure Chemical Vapour Deposition (LPCVD), Diffusion and oxidation furnace
Features:
LPCVD, Oxidation (wet and dry), H2 and N2 tempering, temperature range up to 1250°C

Wet Benches
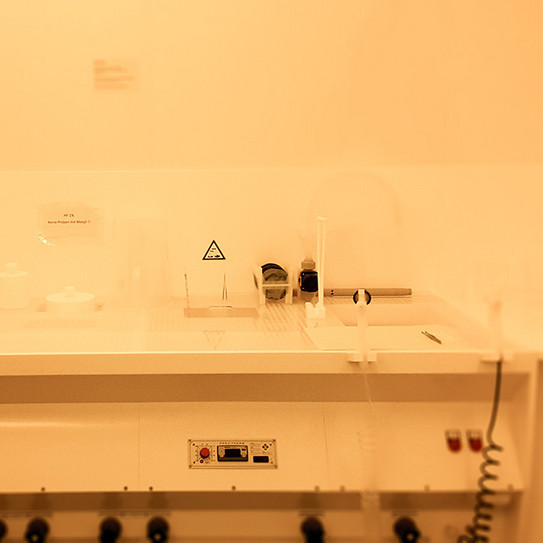
Description:
Wet etching processes for SiO2, Si3N4, Al and Au

Beschreibung:
Development of various resists (AZ resists, PMMA etc.)

Description:
Wafer cleaning SC1, SC2
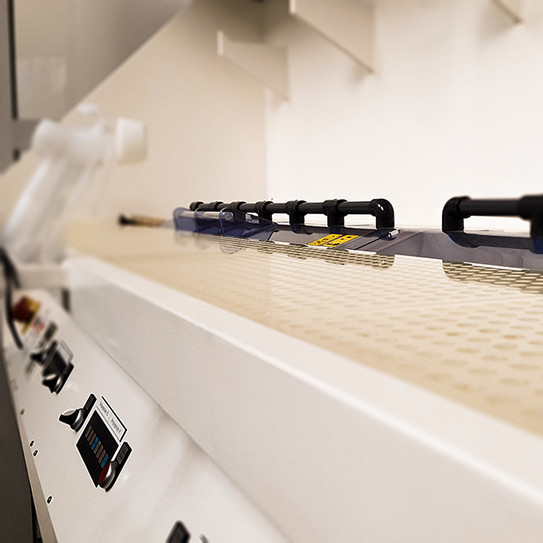
Description:
Cleaning of horizontal furnaces

Description:
Spin Rinser
Cleanroom
Description:
Fan Filter Units
Features:
Laminar flow areas at each working station
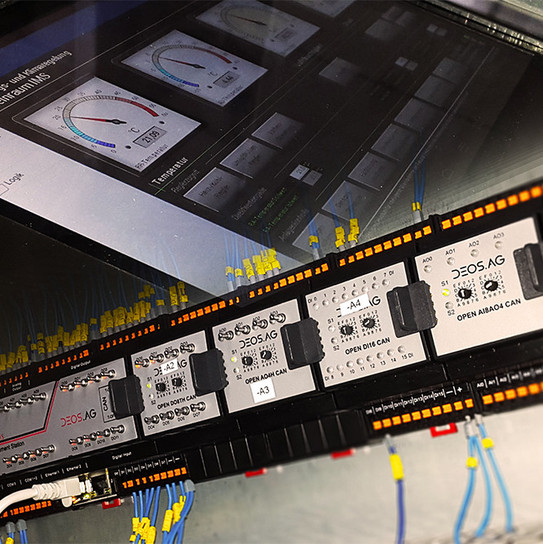
Beschreibung:
Air treatment according to ISO 14644, 21.0°C, 45%rF, 12 Pa overpressure
Features:
DEOS OPEN 500EMS, Carrier 30RA160B, 158kW cooling capacity, Vapac LE90 electrode humidifier
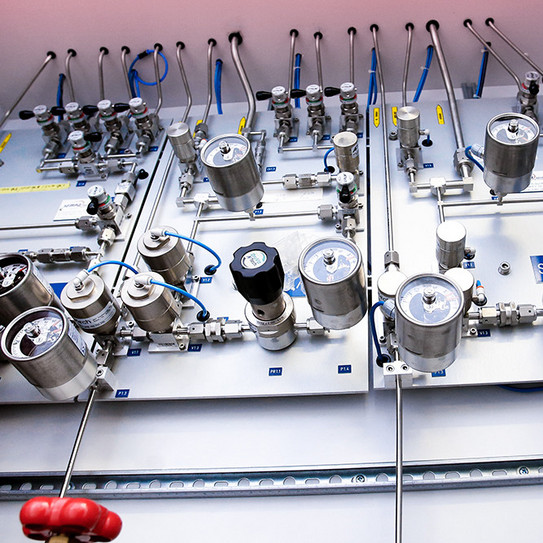
Description:
SPS supported custom design
Features:
Provides O2, N2, Ar, Cl2, SiCl4, H2, N2O, CF4, CHF3, SF6, NH3, SiH4/Ar, SiH2Cl2

Description:
Ultrapure Water Supply (UV treated)

Others

Description:
In-House development
Sample-To-Sample Transferprozesse of 2D nanomaterials

Description:
Wafer Saw
Features:
Wafer sizes ranging from 25.4 to 152.4 mm, wafer thicknesses ranging from 10 to 5000 µm, blade rotation 15000 - 45000 RPM

Description:
Portable Leak Detector

Portable Helium Leak Detector

<font face="Akkurat-Bold, sans-serif">Description:</font>
Rapid Thermal Annealing up to 1200°C in Ar/H2/N2 atmosphere, substrate sizes up to 6 Inches
Description:
n/a
Description:
C4 galvanic solder deposition (bumps)

Description:
Ultrasonic Heavy Wire Bonder (400µm)