Labortechnik und Anlagen
Externe Forschungseinrichtungen können im Rahmen gemeinsamer Kooperationsprojekte oder über den ForLab-Verbund Zugang zu unserer Forschungsinfrastruktur erhalten. Für Industriepartner besteht zudem die Möglichkeit einer Zusammenarbeit im Rahmen wirtschaftlicher Drittmittelprojekte. Ihr Ansprechpartner ist Prof. Dr. Stefan Tappertzhofen

Analytik
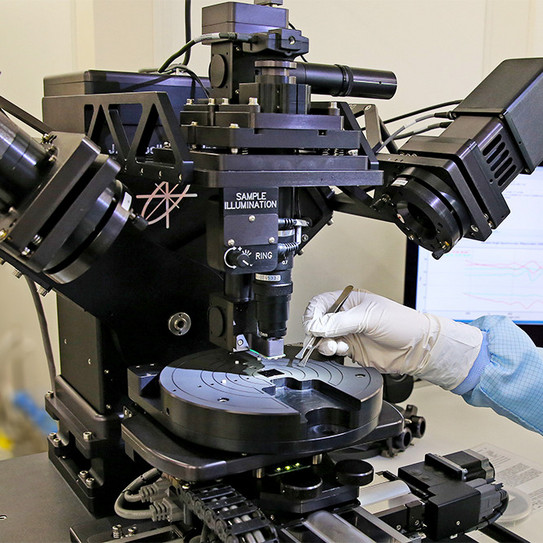
Typ:
Ellipsometer
Beschreibung:
Schichtdickenmessung und Parameterextraktion
Status:
Voll funktionsfähig

Typ:
Rasterelektronenstrahlmikroskop (REM)
Beschreibung:
Deben Beam Blanker, Kleindiek Nanotechnik Stage, Xenos Pattern Generator, Auflösung bis zu 0,7nm
Kooperation mit Terahertz Spectroscopy Group (AG Lange)
Status:
Voll funktionsfähig
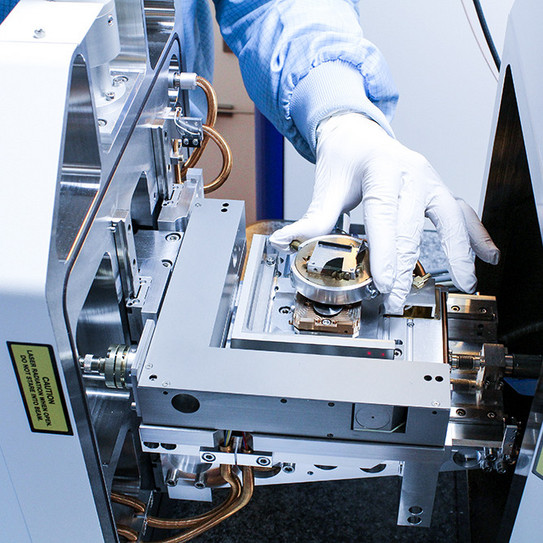
Typ:
Rasterelektronenmikroskop (REM)
Beschreibung:
Bis zu 10 nm Auflösung, InLens und SE-Detektor
Status:
Voll funktionsfähig

Typ:
Rasterelektronenmikroskop (REM)
mit PointElectronic Elektronik Upgrade und Raith ELPHY Quantum
Beschreibung:
Bis zu 10 nm Auflösung mit einem 4k Imaging-System und Topologiedarstellung, InLens-, SE- und BSE-Detektor
Status:
Voll funktionsfähig

Typ:
EDX System
Beschreibung:
Low-KV EDX-System, ≤127eV @ MnKα, Detektion der Elemente ab Beryllium (Z=4)
Status:
Voll funktionsfähig

Typ:
Digitales Lichtmikroskop
Beschreibung:
Bis zu 5000-fache Vergrößerung
Status:
Voll funktionsfähig
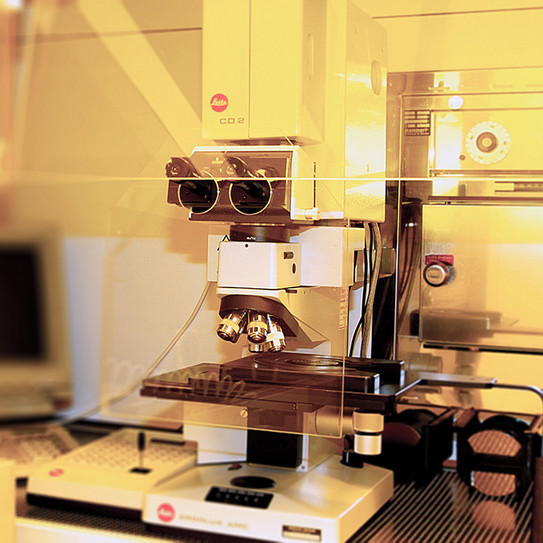
Typ:
Strukturbreitenmesssystem
Beschreibung:
Laser-Autofokus
Status:
Voll funktionsfähig
Typ:
Systemmikroskop
Beschreibung:
Optisches UIS2/UIS (Universal Infinity System)-System
Status:
Voll funktionsfähig

Typ:
Konfokalmikroskop
Beschreibung:
Konfokales Lasermikroskop
Status:
Voll funktionsfähig

Typ:
Profilometer
Beschreibung:
Oberflächenprofilometrie
Status:
Voll funktionsfähig
Typ:
Raman Spektroskopie und Atomkraftmikroskopie
Beschreibung:
2 Laser-Quellen (355 nm und 488 nm), Linkam-Stage (196 °C bis +600 °C in variabler Atmosphäre) mit Mikromanipulatoren und Messnadeln, Atomkraftmikroskopie (AFM, CAFM)
Status:
Voll funktionsfähig

Elektrische Messtechnik
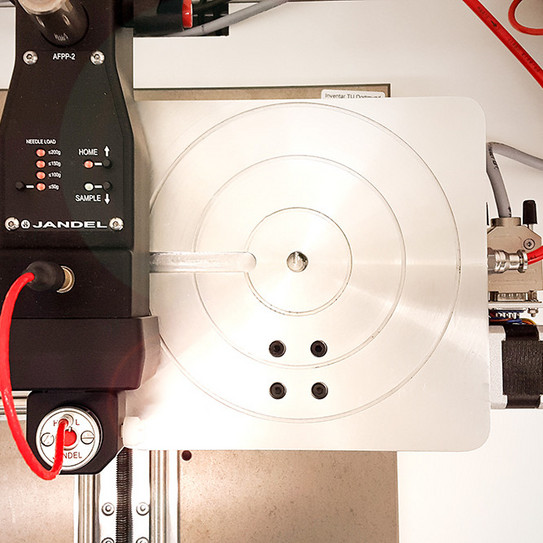
Typ:
4-Spitzen-Messplatz
Beschreibung:
Flächenwiderstandsmessung auf Probenstücken und Wafern
Status:
Voll funktionsfähig
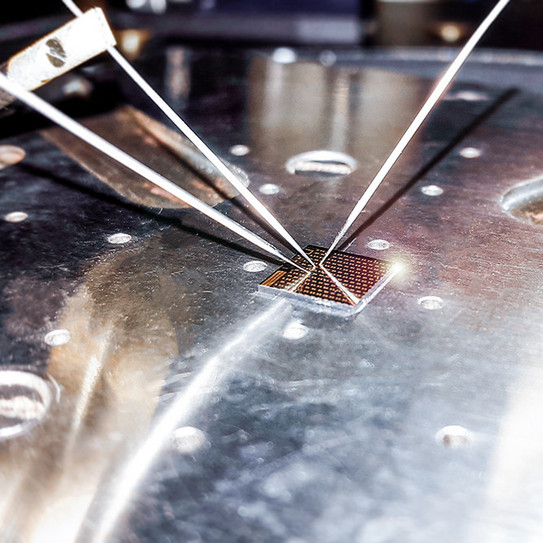
Typ:
Spitzenmessplatz
Beschreibung:
Lichtgeschützter Aufbau mit Vakuum-Chuck (8 Messnadeln)
Status:
Voll funktionsfähig

Typ:
Parameter Analyser
Beschreibung:
Precision Semiconductor Paramter Analyzer
Status:
Voll funktionsfähig
Typ:
Waferprober
Beschreibung:
Vollautomatischer Waferprober zur statistischen Vermessung von Bauelementeparametern
Status:
Voll funktionsfähig
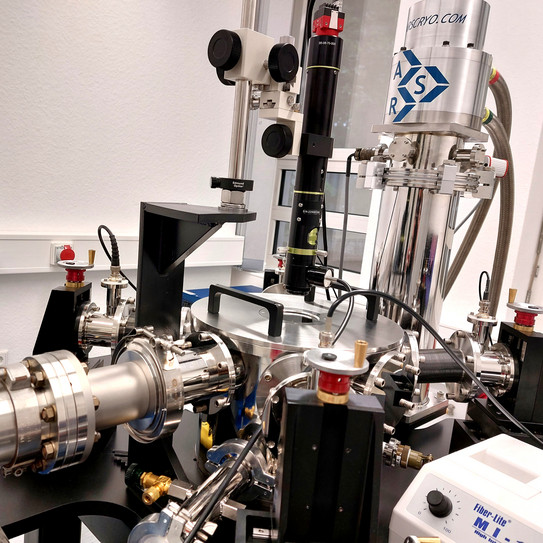
Typ:
Probestation für Tiefsttemperaturmessung
Beschreibung:
Closed Cycle Cryogenic Probe Station, Heliumkompressor, Beryllium DC probe Tips
Status:
Voll funktionsfähig
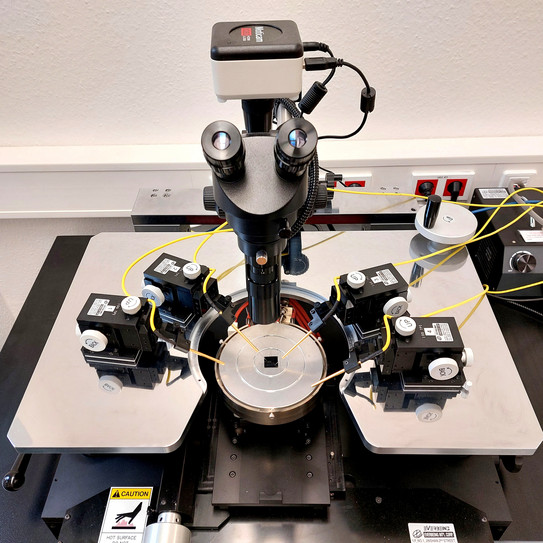
Typ:
RF-Waferprober
Beschreibung:
HF Messung bis 40GHz, Temperatur bis 200°C, ausschließlich metrische Schrauben
Status:
Voll funktionsfähig
Typ:
Impedanz-Analysator
Beschreibung:
Impedanzanalysator und Präzisions-LCR-Messgerät, 1 mHz bis 500 kHz, 1 mΩ bis 1 TΩ, Erweiterung auf 5 MHz
Status:
Voll funktionsfähig
Typ:
DC - 600 MHz Lock-in Amplifier, 14 bits, 1.8 GSa/s, ±150 mV, ±1.5 V (high-impedance load), -12.5 dBm, 7.5 dBm (50 Ω load), Spectrum Analyzer
Status:
Voll funktionsfähig
Typ:
Source Meter Unit (Range 1 aA - 100 mA, 1 µV - 200 V)
Status:
Voll funktionsfähig
Typ:
Source Meter Unit (0.1 fA - 10 A, 5 µV - 200 V)
Status:
Voll funktionsfähig
Typ:
Digital Nano-Voltmeter (< 1 µV - 100 V)
Status:
Voll funktionsfähig
Typ:
4x 1 GHz (5 GSPS) Oszilloskop
Status:
Voll funktionsfähig

Ätzanlagen

Typ:
Inductive Coupled Plasma (ICP), Reaktives Ionenätzen (RIE)
Beschreibung:
12 verschiedene Gaslinien, Fluor- Chlor und Brom-Prozesse, End-Point Detektion
Status:
Inbetriebnahme
Typ:
Inductive Coupled Plasma (ICP), Reaktives Ionenätzen (RIE)
Beschreibung:
Fluor- und Chlor-Prozesse
Status:
Inbetriebnahme
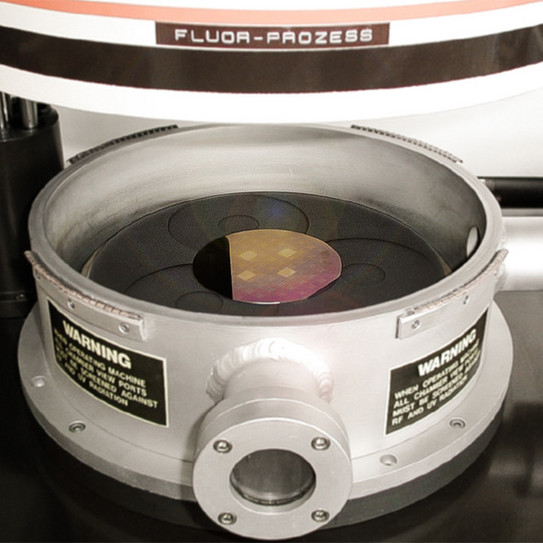
Typ:
Reaktives Ionenätzen (RIE)
Beschreibung:
Chlorprozesse: SF6, Cl2, CHF4, SiCl4, N2; Fluorprozesse:SF6, O2, Ar, CHF3, N2
Status:
Voll funktionsfähig

Typ:
Reaktives Ionenätzen (RIE)
Beschreibung:
Fluorprozesse: SF6, O2, Ar, CHF3, N2
Status:
Voll funktionsfähig
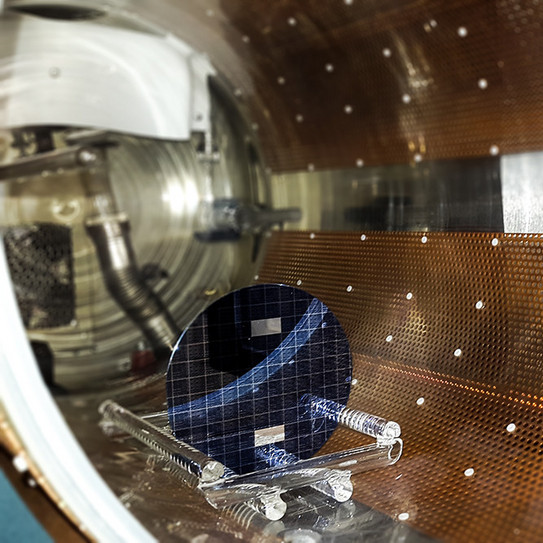
Typ:
Plasmaverascher
Beschreibung:
Ätzen im Sauerstoffplasma, maximal 8 Zoll Wafer
Status:
Voll funktionsfähig
Implantations- und Dotierungstechnologie

Typ:
Ionenimplanter
Beschreibung:
Dotierung mit einer Flächendosis von bis zu 10e16 cm-2 und max. 350 keV.
Verfügbare Ionenquelle: High Voltage Engineering Gasquelle SO-70 und Danfysik Feststoffquelle SO-55 für unter anderem B-, P-, As-Verbindungen, HVE Sputterquelle SO-90 für Al-, Cr, Fe, Ge und Er.
Status:
Voll funktionsfähig
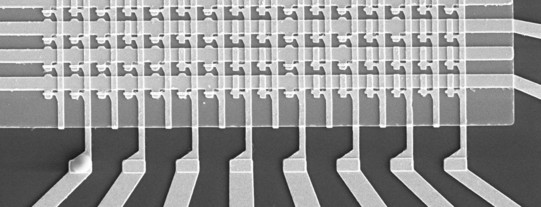
Lithografie

Typ:
Elektronenstrahllithografie
Beschreibung:
Strukturgrößen bis zu 10 nm auf Die-Substraten, Laserinterferometer gesteuertes Stitching
Status:
Voll funktionsfähig

Typ:
Elektronenstrahllithografie
Beschreibung:
mit PointElectronic Elektronik Upgrade und Raith ELPHY Quantum Lithografie-Erweiterung, Strukturgrößen bis zu 10 nm auf Die-Substraten
Status:
Voll funktionsfähig

Typ:
Elektronenstrahllithographie
Beschreibung:
Deben Beam Blanker, Kleindiek Nanotechnik Stage, Xenos Pattern Generator, Auflösung bis zu 0,7nm
Kooperation mit:
Terahertz Spectroscopy Group (AG Lange)
Status:
Voll funktionsfähig
Typ:
Direktbelichter
Beschreibung:
300 nm minimale Strukturauflösung
Status:
Wird gewartet
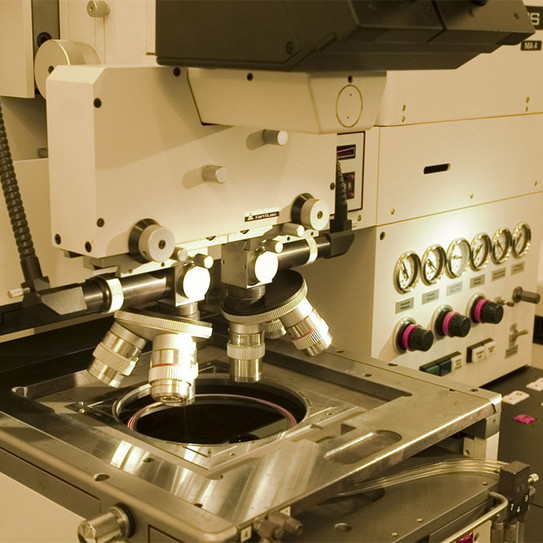
Hersteller/Typ:
Optisches Belichtungssystem
Beschreibung:
Strukturweiten bis 0,6 um auf 4 Zoll-Substrat
Status:
Voll funktionsfähig

Typ:
Optisches Belichtungssystem
Beschreibung:
Strukturweiten bis 0,6 um auf 4 Zoll-Substrat
Status:
Voll funktionsfähig

Typ:
Belackungssystem, Spincoater
Beschreibung:
Bis 200 mm Wafer bei 0 - 12000 UPM
Status:
Voll funktionsfähig
Typ:
Belackungssystem Spincoater
Beschreibung:
Bis 200 mm Wafer bei 0 - 12000 UPM (Silikone)
Status:
Voll funktionsfähig

Schichterzeugung
Typ:
Atomic Layer Deposition
Beschreibung:
Thermische ALD bis 500°C, Glovebox, Picozone™ PZ-100 ozone generator, Precursor: TMA, TEMAHf, H2O, NH3
Status:
Voll funktionsfähig

Typ:
Plasmaunterstützte chemische Gasphasenabscheidung (PECVD)
Beschreibung:
Schichtenerzeugung mittels chemischer Gasphasenabscheidung
Status:
Voll funktionsfähig
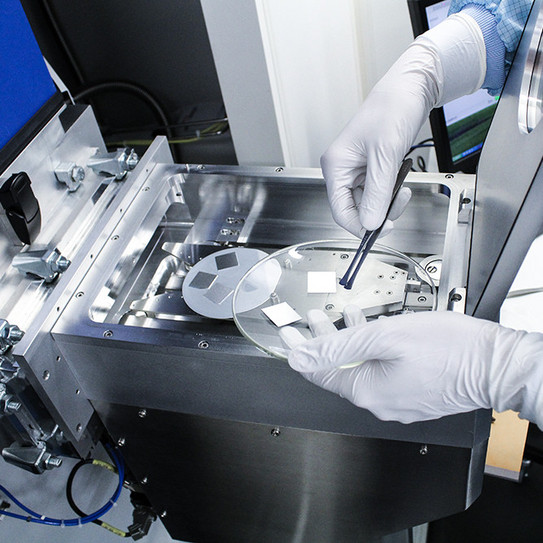
Typ:
Reaktive Magnetron-Sputteranlage
Beschreibung:
Physikalische Abscheidung von Schichten (u.a. Al, Ti [ TiN reaktiv], Ni, Si)
Status:
Voll funktionsfähig

Typ:
Reaktive (N2 + O2) Magnetron-Sputteranlage (DC/HF) mit Plasus 2-Kanal Plasma-Emissionsmonitor (PEM) im Bereich von 200...1100nm
Beschreibung:
Abscheidung von ITO, Lanthanhexaborid, Samarium, Yttrium, Bismuttellurid, Niob(-oxid) und Hafnium(-oxid)
Status:
Voll funktionsfähig
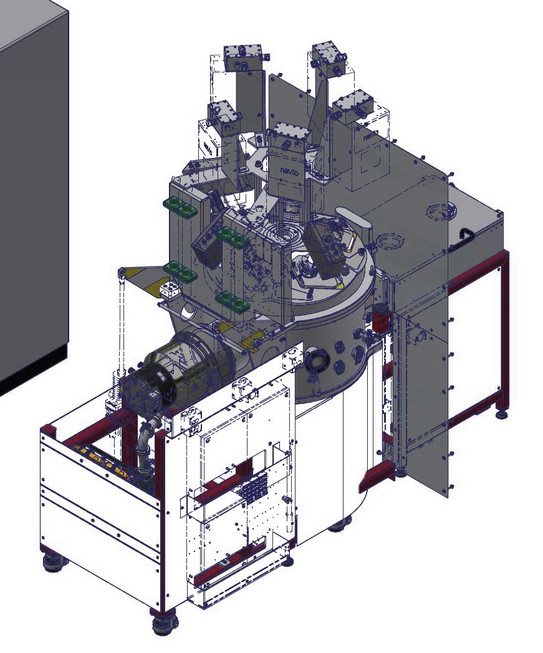
Typ:
Konfokales DC/RF Magnetron-Sputter-System mit Plasma-Emissionsmonitor (PEM)
Beschreibung:
Abscheidung von Chrom, Niob(-oxid) und Hafnium(-oxid) sowie weiteren Materialien
Status:
- beauftragt -

Typ:
Aufdampfanlage
Beschreibung:
Al- und Cr-Target vorhanden
Status:
Voll funktionsfähig

Typ:
Diffusions- und Oxidationsöfen
Beschreibung:
Oxidation (nass und trocken), H2 und N2 Temperung
Status:
Voll funktionsfähig
Typ:
Low Pressure Chemical Vapour Deposition (LPCVD), Diffusions- und Oxidationsöfen
Beschreibung:
LPCVD, Oxidation (nass und trocken), H2 und N2 Temperung, Temperatur bis 1250°C
Status:
Voll funktionsfähig

Nassbänke
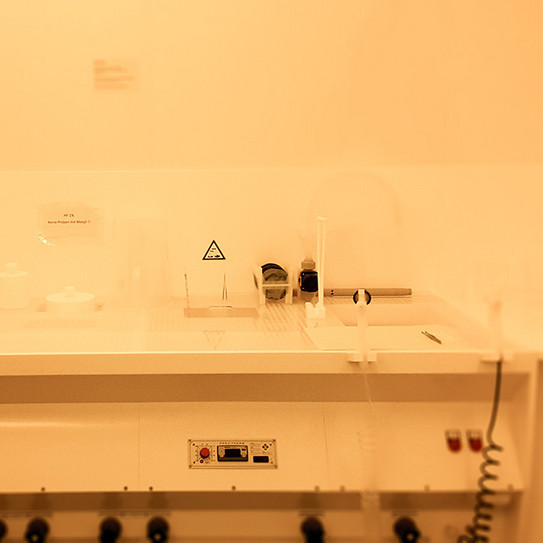
Typ:
Nassätzbank
Beschreibung:
Nassätzprozesse für SiO2, Si3N4, Al und Au
Status:
Voll funktionsfähig

Typ:
Entwicklerbank
Beschreibung:
Lackentwicklung (AZ-Lacke, PMMA etc.)
Status:
Voll funktionsfähig

Typ:
Reinigungsbank
Beschreibung:
Waferreinigung SC1, SC2
Status:
Voll funktionsfähig
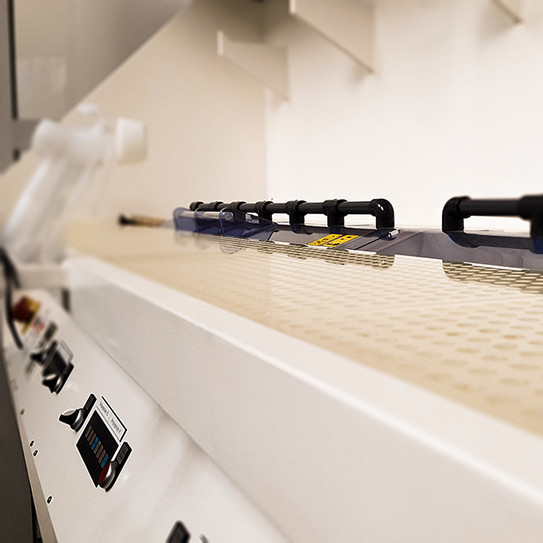
Typ:
Rohrwaschanlage
Beschreibung:
Reinigung für Horizontalöfen
Status:
Voll funktionsfähig

Typ:
Spin Rinser
Beschreibung:
k.A.
Status:
Voll funktionsfähig
Reinraum
Typ:
Fan-Filter-Units
Beschreibung:
Laminar-Flow Bereiche an sämtlichen Arbeitsbereichen
Status:
Werden teilweise gewartet
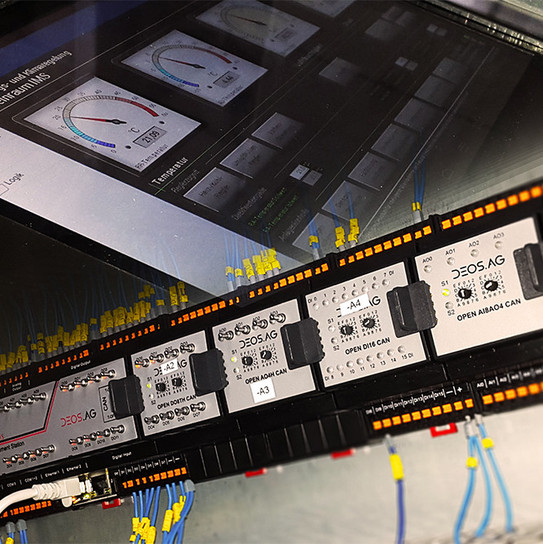
Hersteller/Typ:
DEOS OPEN 500EMS, Carrier 30RA160B, 158kW Kühlleistung,Vapac LE90 Elektrodenbefeuchter
Beschreibung:
Luftaufbereitung nach ISO 14644, 21,0°C, 45%rF, 12 PaÜberdruck
Status:
Voll funktionsfähig
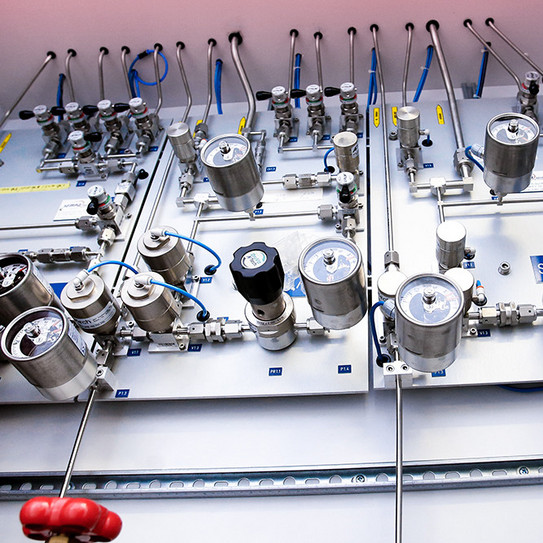
Typ:
SPS gestützte Sonderanfertigung
Beschreibung:
O2, N2, Ar, Cl2, SiCl4, H2, N2O, CF4, CHF3, SF6, NH3, SiH4/Ar, SiH2Cl2
Status:
Voll funktionsfähig

Typ:
Reinstwasseranlage
Beschreibung:
Reinstwasser-Bereitstellung (UV behandelt)
Status:
Voll funktionsfähig

Sonstiges

Typ:
Eigenentwicklung
Beschreibung:
Sample-To-Sample Transferprozesse von 2D-Nanomaterialien
Status:
Voll funktionsfähig

Typ:
Wafersäge
Beschreibung:
Wafergröße 25.4 - 152.4 mm, Waferdicke 10 - 5000 um, Blattrotation 15000 - 45000 UPM
Status:
Voll funktionsfähig

Typ:
Schnüffellecksucher
Beschreibung:
Portable Leak Detector
Status:
Voll funktionsfähig

Typ:
Schnüffellecksucher
Beschreibung:
Portable Helium Leak Detector
Status:
Voll funktionsfähig

Typ:
Rapid Thermal Annealing
Beschreibung:
Rapid Thermal Annealing bis 1200°C in Ar, H2, N2Atmohsphäre, bis 6 Zoll
Status:
Wird gewartet
Hersteller/Typ:
Einzeldraht-Ultraschall-Bonder
Beschreibung:
k.A.
Status:
Voll funktionsfähig
Typ:
Flip Chip Bonder
Beschreibung:
C4 Galvanische Lotabscheidung (Bumps)
Status:
Im Aufbau

Typ:
Dickdraht Ultraschall-Bonder
Beschreibung:
Dickdraht (400μm) Ultraschall-Bonder
Status:
Voll funktionsfähig